Chips ficam 50% menores com capacitores enfiados em camada intermediária
Redação do Site Inovação Tecnológica - 14/06/2021
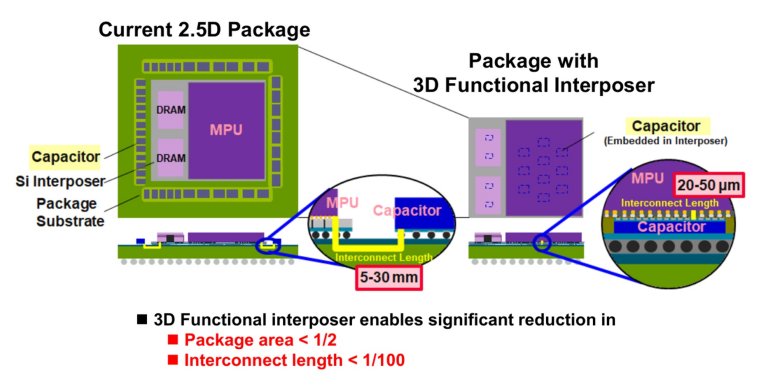
[Imagem: Yi-Chieh Tsai et al. - 10.1109/TED.2021.3082497]
Miniaturização
Engenheiros japoneses descobriram como usar uma camada "inerte" dentro dos processadores para colocar componentes ativos.
Esse melhor aproveitamento da área permitiu um nível de compactação e miniaturização impressionante, além de reduzir as fiações no interior do próprio chip.
A técnica consiste em construir um componente eletrônico chamado capacitor dentro de uma camada conhecida como "interposer", que funciona como um espaçador, isolante e guia de conexões entre os transistores e a fiação do chip.
Yi-Chieh Tsai e colegas do Instituto de Tecnologia de Tóquio demonstraram que as camadas intermediárias de silício podem ser transformadas em capacitores funcionais, economizando um espaço considerável e trazendo vários outros benefícios.
Nos chips mais modernos, incluindo as DRAMs e os processadores, esses interposers funcionam como túneis condutores verticais, que unem as conexões nos chips com saliências de solda no substrato da embalagem. Os capacitores são colocados nesse substrato, próximo aos componentes aos quais servem, o que exige uma conexão de 5 a 30 mm entre seus terminais e os do chip.
A nova proposta é que a própria camada de silício funcione como capacitor.
A equipe conseguiu isso por meio de um novo processo de fabricação no qual os capacitores são incorporados dentro de uma peça de silício de 300 mm usando resina e cola. As interconexões entre o chip e o capacitor são feitas diretamente com vias passantes de silício, sem a necessidade de saliências de solda.
"Nosso interposer funcional 3D, sem saliências [as protuberâncias das soldas], permite uma redução notável na área do pacote de cerca de 50% e um comprimento de interconexão cem vezes menor," comentou o professor Takayuki Ohba.
Artigo: Electrical Characteristics and Reliability of Wafer-on-Wafer (WOW) Bumpless Through-Silicon Via
Autores: Yi-Chieh Tsai, Chia-Hsuan Lee, Hsin-Chi Chang, Jui-Han Liu, Han-Wen Hu, Hiroyuki Ito, Young Suk Kim, Takayuki Ohba, Kuan-Neng Chen
Revista: Proceedings of the IEEE Electronic Components and Technology Conference
Vol.: 99:1-6
DOI: 10.1109/TED.2021.3082497


Processador fotônico roda por horas a temperatura ambiente
Escultura eletrônica: Componentes têm propriedades ditadas pela geometria
Projetado primeiro detector de grávitons, as partículas da gravidade
Luz é focalizada e desfocada no espaço livre, sem lentes
Descoberto material metálico com condutividade térmica recorde
Computador neuromórfico conecta matemática, inteligência e neurociência
Buracos de minhoca não existem, Big Bang é um portal e o tempo vai e vem, propõem físicos
Cristal do tempo levita e desafia Terceira Lei de Newton
Tensão de Hubble surge da física real, e não de erros de medição
Bateria de nióbio inédita é criada na USP
Escultura eletrônica: Componentes têm propriedades ditadas pela geometria
Laser de som cria terremoto dentro de um chip
Engenharia de origami viabiliza micromáquinas totalmente controláveis
Sensores sem bateria monitoram sua saúde sem lhe incomodar
Menor capacitor do mundo impulsiona as medições quânticas
Gerador de fótons para computadores quânticos agora cabe em um chip
Todos os direitos reservados.
É proibida a reprodução total ou parcial, por qualquer meio, sem prévia autorização por escrito.



